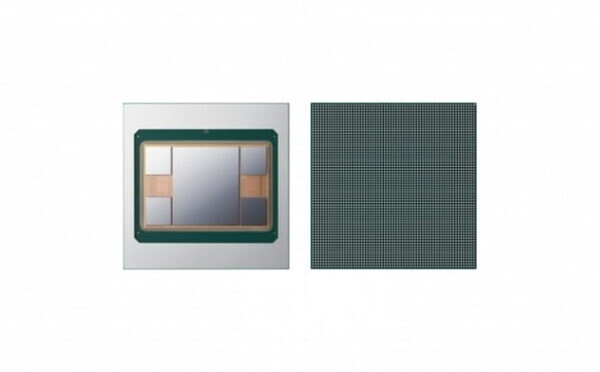
삼성전자가 차세대 반도체 패키지 기술 'I-Cube4'를 개발했다. I-Cube4는 로직 칩과 4개의 HBM(High Bandwidth Memory) 칩을 하나의 패키지로 구현한 독자 구조의 2.5D 패키지 기술이다. 고대역폭 데이터 전송과 고성능 시스템 반도체를 필요로하는 HPC(High Performance Computing), AI/클라우드 서비스, 데이터센터 등을 중심으로 폭넓게 활용될 것으로 기대된다.
I-Cube4는 실리콘 인터포저 위에 로직과 HBM을 배치해 하나의 반도체처럼 동작하도록 하는 이종 집적화(Heterogeneous Integration) 패키지 기술이다. 이 기술을 통해 한 개의 패키지 안에 여러 개의 칩을 배치해 전송 속도는 높이고 패키지 면적은 줄일 수 있다.
I-Cube4는 실리콘 인터포저(Si-Interposer)를 적용해 초미세 배선을 구현했으며, 안정적으로 반도체 구동을 위한 전력을 공급할 수 있다. 또, 인터포저는 IC칩과 PCB 상호 간의 회로 폭 차이를 완충시키는 역할을 한다.
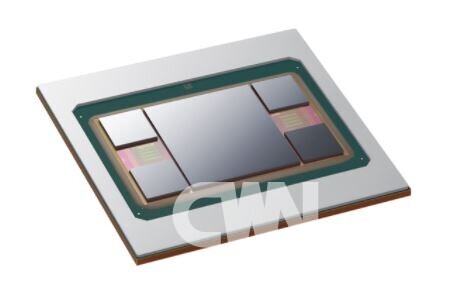
일반적으로 패키지 안의 반도체 칩의 개수가 많아질수록 인터포저의 면적도 함께 증가해 공정상의 어려움이 커진다. 하지만, 삼성전자는 100마이크로미터 수준의 매우 얇은 인터포저가 변형되지 않도록 재료, 두께 등 다양한 측면에서 반도체 공정과 제조 노하우를 적용했다. 또한, 몰드를 사용하지 않는 독자적인 구조를 적용해 효율적으로 열을 방출할 수 있도록 했다.
삼성전자는 패키지 공정 중간 단계에서 동작 테스트를 진행해 불량을 최소화하도록 노력하였고 전체 공정 단계를 줄여 생산 기간을 단축했다.
[저작권자ⓒ CWN(CHANGE WITH NEWS). 무단전재-재배포 금지]
























![[구혜영 칼럼] 사회복지교육은 미래복지의 나침반이 되어야](/news/data/2026/01/16/p1065596364370517_157_h.png)






